LED封装技术现状及发展展望
导读:
技术进步和市场需求是LED产业发展的两大动力。LED封装经历了各种封装形态的传统正装封装和有引线倒装封装发展历程。随着市场需求变化、LED芯片制备技术和LED封装技术的发展,LED封装将主要朝着高功率、多芯片集成化、高光效及高可靠性、小型化的方向发展。
从中国LED封装发展历程上看,有传统正装封装用LED芯片、有引线覆晶(Flip-Chip)封装用LED芯片和无引线覆晶封装用LED芯片等几种结构,无引线覆晶LED封装技术是未来LED封装的主流技术。
一、LED 封装发展历程和发展趋势
随着芯片技术发展和市场对更高亮度的需要,各种形态的封装产品大量产生,从早期的引脚式LED器件、贴片式印制电路板(P C B)结构、聚邻苯二酰胺(P P A)、聚对苯二甲酸己二甲醇酯(P C T)及热固性环氧树酯(E M C)结构L E D器件到现今的氮化铝陶瓷结构、高功率集成板上芯片封装(Chip On Board,COB)、各类覆晶等不同形态的封装。中国LED封装形式的演变如图1所示。

未来LED封装将围绕照明应用,主要朝着高功率、小型化、多芯片集成化、高光效及高可靠性方向发展。为提升白光LED器件流明成本效率,解决封装器件大电流高功率工作条件下的散热、实现高光效及高可靠性等技术问题将成为新的主题。
二、正装封装和覆晶封装优缺点
LED封装可以简单分为正装芯片封装与覆晶封装。覆晶封装又分为有引线覆晶封装和无引线覆晶封装。覆晶封装是利用LED倒装芯片与各种封装材料通过特定的技术方案进行有效组合成产品的封装工艺。倒装芯片之所以被称为“倒装”,是相对于正装封装金属线键合(Wire Bonding)连接方式的工艺而言。正装封装的LED芯片电气面朝上,而LED倒装芯片的电气面朝下,相当于将前者翻转过来,故称其为“倒装芯片”,倒装LED芯片的光从蓝宝石衬底取出,不必从电流扩散层取出,不透光的电流扩散层可以加厚,增加电流密度。
1、LED 正装芯片封装
正装芯片封装采用银胶或白胶将芯片固定在基板上,通过引线实现电气连接。银胶或白胶含环氧树脂,长期环境稳定性较差,其热阻较高,在LED长时间通电过程中粘接力逐渐变差,易导致LED寿命缩短;且引线很细,耐大电流冲击能力较差,仅能承受10g左右的作用力,当受到冷热冲击时,因各种封装材料的热失配,易导致引线断裂从而引起LED失效。单颗LED芯片正装结构如图2所示。
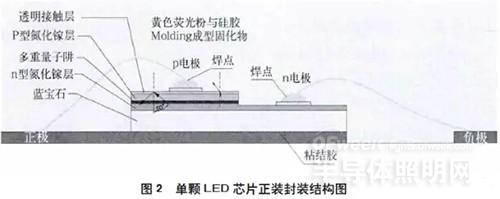
LED正装芯片封装的优点是:①芯片制备工艺成熟;②封装工艺比较成熟。
LED正装芯片封装的缺点是:①电极、焊点、引线遮光;②热传导途径很长:蓝宝石粘结胶支架金属基板;③热传导系数低:蓝宝石热传导率为20W / (m·K)、粘结胶热传导率为2W/ (m·K);④热积累影响芯片和荧光粉可靠性。
相关阅读:
| ・鸿利光电募资7亿加码LED封装及收购 08/05 |
| ・福日电子1.2亿收购源磊拓展LED封装业务 10/27 |
| ・欧司朗无锡LED封装厂正式投产 05/28 |
| ・我国LED封装用设备的发展情况 04/24 |
| ・各种LED封装基板的散热性比较 03/29 |
| ・LED封装技术及其发展趋势 03/29 |

